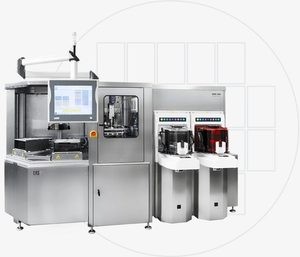
ERS ADM300系統設計用於與扇出型晶圓級別封裝技術(FOWLP)技術相關的晶圓和載體的全自動分離。該機器是通過釋放熱量從而剝離載體。隨後,採用專有的熱處理工藝來減少並控制因為拆鍵合,重構晶圓而引發的翹曲。相對於被拆鍵合的晶圓的品質,該系統具有高度的結果重複性。
ADM300內部集成的鐳射劃片區域使得對拆鍵合下游工藝的生產相關資料的100%監控成為可能。ADM300配備了可連續運行的,用於300mm或330mm的FIOWLP晶圓可選的FOUP卸載功能。該系統具有OCR/BCR功能,並配備完善的SECS/GEM介面集成。系統讀取載體上的ID,然後通過SECS/GEM介面將此ID編號傳遞給工廠伺服器。這樣就可以從伺服器下載方案,也可以將結果資料上傳到伺服器。可以上傳來自自動拆鍵合、自動脫膠、自動晶圓劃片(和ID讀取檢查)、以及來自高精度翹曲檢測站的資料。可以即刻再次使用載體。
FOWLP文章連結:ERS的扇出型封裝技術
| Wafer size | 300 mm/ 330mm |
| Handling system | One 3 and one 4-Axis Robot; special endeffector |
| Debond System | Thermal, force controlled |
| Detape System | Vacuum and mechanical |
| Detape Angle | Adjustable within 45° |
| Maximum Input Warpage | +/- 5mm |
| Warpage Adjust Method | ERS TriTemp Slide |
| Typical Output warpage | < 500µm |
| UPH | Up to 25 depending on product |
| Temperature control | DC PID and ERS AirCool® components |
| Temperature range | -10°C up to +260°C (depending on station) |
| Debond Force | Adjustable |
| Laser marking | Diode-pumped system, 1064 nm |
| Oxygen Free Environment | Optional |
| W x D x H | 3126mm x 1856mm x 2105mm |
| Weight | 2200kg |
| Voltage | 400 VAC 3 Phase 32A |
| Frequency | 50 / 60 Hz |
| Power | 20 kW |
| CDA pressure | 6 bar at 0 °C Dewpoint |
| CDA flow rate | 1000 l/min peak |
| Vacuum pressure | 100 mbar |
| Vacuum flow rate | 100 l/min |
ERS electronic GmbH 總公司設立於德國,致力於提供半導體產業創新的晶圓溫度測試解決方案逾 50 年;ERS 開發及生產之熱卡盤系統系列產品:AC3、AirCool © 、AirCool © Plus 及 PowerSense © 銷售全球,是大尺寸晶圓針測機中不可或缺的產品。ERS 還開發eWLB制程設備,用於去載板和去載板後的產品去翹曲。超過10年的服務該領域,不斷完善設備和工藝。ERS可以為客戶提供優良的FOWLP和FOPLP的優良的工藝設備,以及保證工藝完成的De-warpage設備。